【導讀】超結功率半導體器件是一類具有超結耐壓層的重要器件,超結將PN結引入到常規“電阻型”耐壓層中,使之質變為“結型耐壓層”,這種質變突破傳統功率器件比導通電阻和耐壓之間的Ron,sp ∝VB2.5“硅極限”關系,使之降低到Ron,sp ∝VB1.32,甚至 Ron,sp ∝VB1.03,超結器件也因此被譽為功率半導體器件的“里程碑”。從耐壓層角度回顧功率半導體40年發展的3個里程碑,綜述了超結的發明、概念與機理、技術與新結構,并總結超結發展歷程與趨勢。
摘 要
超結功率半導體器件是一類具有超結耐壓層的重要器件,超結將PN結引入到常規“電阻型”耐壓層中,使之質變為“結型耐壓層”,這種質變突破傳統功率器件比導通電阻和耐壓之間的Ron,sp ∝VB2.5“硅極限”關系,使之降低到Ron,sp ∝VB1.32,甚至 Ron,sp ∝VB1.03,超結器件也因此被譽為功率半導體器件的“里程碑”。從耐壓層角度回顧功率半導體40年發展的3個里程碑,綜述了超結的發明、概念與機理、技術與新結構,并總結超結發展歷程與趨勢。
引 言
功率半導體器件是電能轉換與控制的核心器件,所有電子產品均離不開功率半導體器件,無論是毫瓦級的便攜式終端,還是兆瓦級的高鐵?,F代功率半導體技術已被廣泛應用于國民經濟的方方面面,從傳統的工業電子、擴展到信息通訊、計算機、消費和汽車領域,新能源、軌道交通、電動汽車和智能電網正成為功率半導體市場增長的強大引擎。
在這些應用中,功率MOS和以其為核心的功率集成芯片在整個功率半導體市場份額占比高達74%,在2016年功率單管的118億的銷售中,功率MOS占比達 49%(IHS iSuppli Research,August 30,2017)。超結的出現,使得器件比導通電阻大幅降,被國際上譽為“功率MOS器件的里程碑”,超結的優越特性也帶來了巨大的市場需求,有人預計2020年市場規模將高達22億美元,功率芯片已被視為中國半導體破局的重要領域。
1.功率半導體器件結構3個里程碑
1.1 功率半導體器件與耐壓層
與低壓半導體器件相比,功率半導體器件關態條件下需承受高電壓,具有耐壓層結構,可以看成低壓控制器件與耐壓層形成的復合結構。如圖1所示,功率MOS器件可視為低壓MOS漏端D與準漏端D''之間插入耐壓層的復合結構,其控制部分工作機理與低壓MOS基本相同。功率半導體器件設計的關鍵之一是耐壓層的設計。

圖1.簡化的血糖儀(BGM)框圖
圖1.功率半導體簡化結構
理想的耐壓層應在關態下承受高電壓,在開態下導通大電流,并實現兩者之間的快速轉換。因此,其基本要求是高耐壓、低導通電阻和高開關速度,其優化的本質就是實現特定應用場景下的最佳折衷。
1.2 功率半導體器件結構3個里程碑
20世紀70年代發明的VDMOS,為承受高耐壓采用具有單一導電型的“電阻型”耐壓層,人們很快發現其比導通電阻和耐壓之間存在Ron,sp ∝VB2.5極限關系,使器件功耗隨耐壓劇增。大量研究致力于如何使器件性能盡可能接近甚至突破“硅極限”,從耐壓層演變角度,需要在保證耐壓前提下盡可能增加開態載流子濃度,功率半導體器件呈現了不同的發展階段。
圖2給出功率半導體40年發展的3個里程碑:(a)里程碑I阻型耐壓層器件,器件耐壓層為具有N或P單一導電類型的低摻雜半導體層,其特性受“硅極限”限制,典型結構為常規VDMOS器件;(b)里程碑II電導增強阻型耐壓層,通過將PN結正向注入特性引入到阻型耐壓層中,大注入非平衡載流子增加開態載流子濃度,典型結構為IGBT;(c)里程碑III結型耐壓層,將異型摻雜引入到耐壓層內部形成周期性交替摻雜的耐壓層結構,其特點是將PN結反向耗盡特性引入到耐壓層內部,實現兩區之間的電荷平衡,典型結構為本文重點闡述的超結,耐壓層從“阻型”到“結型”的轉變為耐壓層結構的一次質變。

(a)里程碑Ⅰ:阻型耐壓層 (b) 里程碑Ⅱ:阻型+正向注入
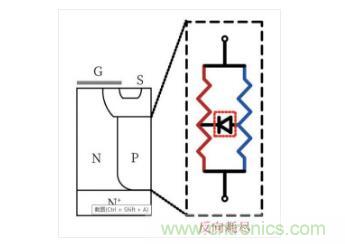
(c)里程碑Ⅲ:結型耐壓層
圖2.功率半導體器件40年發展的3個里程碑
從上面的論述可以看出,耐壓層演變的特點是巧妙地將PN結的正向與反向特性引入常規阻型耐壓層中,從而實現耐壓層電阻降低。
2.超結概念與機理
2.1 二維電荷場調制與電荷平衡
與阻型耐壓層相比,超結結型耐壓層由于內部引入PN結,關態條件下N區電離正電荷發出電場線大部分流向毗鄰P區電離負電荷,在耐壓層內部引入顯著的二維場效應,這種復雜場調制極大降低器件表面電場峰值并優化了體內場分布。結型耐壓層電場線與零電勢邊界條件下由電離電荷產生的電荷場Eq(x,y) 分布,如圖3所示,其中W為超結條寬度,由于耐壓層內部電場線橫向流走,導致AA′上大部分區域電離電荷產生縱向場為零,只有在表面A點所在P+N結位置產生局部電場分布,高電場在縱向很短的距離d(據筆者計算d≈0.78W)范圍內以指數函數迅速衰減,由于對稱性在A′點產生負的電場峰值,BB′線上電場可以類似分析。
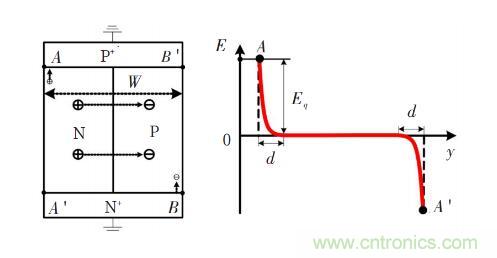
圖3.超結電荷場分布
上述橫向電荷場對縱向電荷場調制使得超結關態條件下二維場分布如圖4所示,結型耐壓層內部電場呈周期函數分布,以耐壓層縱向中線電場為例,峰值位于每個PN結面,谷值位于每個P條或N條中心位置。器件結型耐壓層端面亦呈現周期性峰值分布,與內部不同,其波峰與波谷皆位于每個P條或N條中心位置上,峰值位于上表面P+N結或者下表面N+P結位置,而谷值位于P+P或N+N結位置??v向高電場局限在W距離內,因此耐壓層內部縱向場分布幾乎不受影響。且隨長度增加,高場區保持相同分布且與表面相對位置不變。
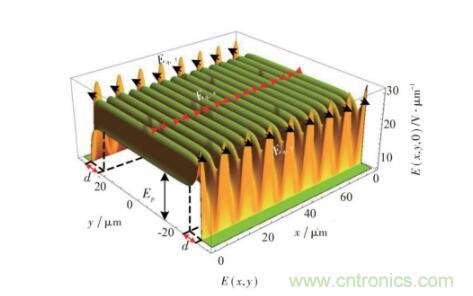
圖4.超結二維電場分布
常規理論認為,理想的超結器件需滿足耐壓層內部電場線全部從N區指向P區,即滿足電荷平衡條件以實現縱向場分量為矩形,電荷非平衡將導致器件耐壓降低。然而筆者發現,在開態條件下,當考慮載流子電荷影響時,巧妙應用電荷非平衡可以降低器件損耗并增加器件的安全工作區。
2.2 超結理論發展
超結器件出現后,不同研究者分別對其進行理論分析:一維近似法將超結在耐壓方向上視為具有均勻場的一維PIN、垂直耐壓方向上視為一維PN結,兩個方向上電場同時達到Ec時最優?;蛘邔⒊Y電場看成耐壓方向與垂直耐壓方向上兩個一維場的疊加,可得到類似結果。一維近似主要用于超結器件的概念分析或者參數估算。
超結二維場優化法建立在二維精確解析場分布的基礎上,其二維精確解在超結發明后很長一段時間才于1998年由電子科技大學陳星弼院士率先提出,進一步將擊穿時耐壓層恰好全耗盡選為優化條件,從而獲得經典Ron,sp ∝VB1.32關系。此外,還提出一種分區求解二維泊松方程的方法,結論類似,不再贅述。
上述優化方法均未給出超結器件的最低比導通電阻Ron,min。由于超結二維場調制效應,研究發現擊穿條件下圖3中A ′和B ′局部非全耗盡時器件Ron,sp更低,筆者團隊基于該特性提出超結非全耗盡(nonfull depletion,NFD)模式,通過全域Ron,sp優化尋求Ron,min,理論上證明新模式下平衡對稱超結滿足:
Ron,sp=1.437×10-3W1.108VB1.03(mΩ·cm²)(1)
圖5給出超結Ron,sp-VB關系與傳統硅極限Ron,sp ∝ VB2.5關系比較,與傳統“硅極限”相比,超結器件Ron,sp正比于超結條寬度W,依賴于元胞尺寸,因此在一定范圍內(W>0.2μm)可以通過工藝改進縮小元胞寬度增加摻雜濃度的形式進一步降低Ron,sp。
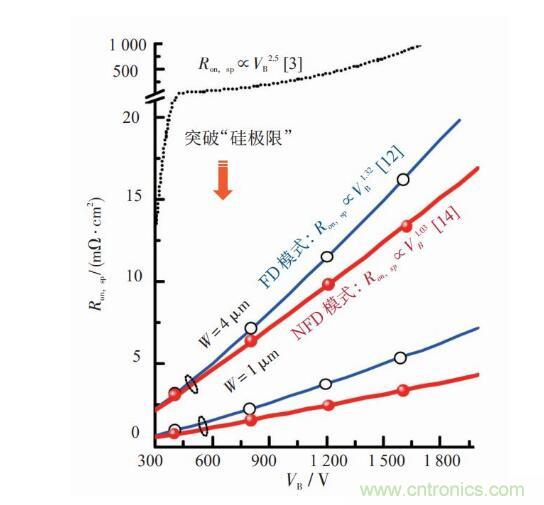
圖5.超結與Ron,sp - VB關系與傳統“硅極限”比較
器件Ron,sp主要由耐壓層長度與摻雜濃度決定,為實現高擊穿電壓,不同類型的耐壓層長度無顯著差異,因此超結突破常規“硅極限”的實質是突破了器件摻雜濃度與VB的依賴關系。圖6給出NFD、FD超結與常規阻型耐壓層濃度變化規律,圖中采用100V器件優化摻雜濃度進行歸一化。由于阻型耐壓層摻雜濃度依賴于耐壓層長度,其優化摻雜濃度隨VB顯著降低,而NFD超結摻雜濃度甚至隨 VB略有增加。這種變化源于結型耐壓層摻雜劑量由超結條寬度W決定,且幾乎獨立于耐壓層長度。
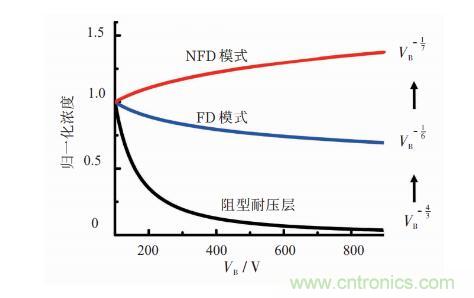
圖6.歸一化摻雜濃度比較
圖7表明超結在不同耐壓級別上都實現了對“硅極限”的突破。以文獻中實驗結果為例,分別采用寬度為1.3μm的P條和1.7μm的N條,實現VB為685V,Ron,sp僅為7.8mΩ·cm²,傳統“硅極限”在相同VB下Ron,sp為 101.9mΩ·cm²,超結器件Ron,sp降低了一個數量級。目前實驗獲得的超結 Ron,sp主要位于式(1)中W為5μm所對應關系以上。

圖7.超結Ron,sp水平
超結概念也被引入到橫向器件中以降低器件的功率損耗,由于橫向超結可以通過表面注入形成且與常規CMOS工藝兼容,橫向超結器件已成為高壓功率集成技術的重要發展方向。與縱向超結器件不同,橫向器件常常將超結置于P型襯底之上,表面超結區由于受到襯底輔助耗盡(substrate-assisted depletion,SAD)效應的影響,導致耐壓降低。
襯底輔助耗盡效應可以通過等效襯底(equivalent substrate,ES)模型描述 ,其原理如圖8所示。將除超結之外的耐壓結構,即電荷補償層(chargecompensation layer,CCL)與襯底視為一個整體,定義為等效襯底ES,研究其整體對表面超結的調制作用。
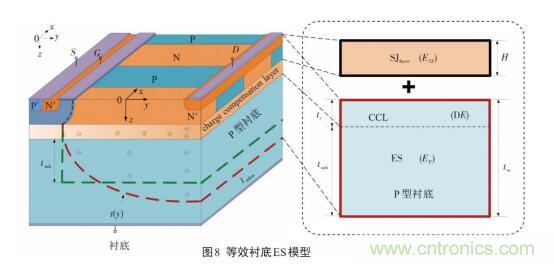
圖8.等效襯底ES模型
ES模型揭示了襯底輔助耗盡效應的本質是襯底電離電荷影響表面超結電荷平衡,致使P條非全耗盡而N條全耗盡,器件耐壓降低。為消除其影響,理論上ES層需滿足的理想襯底條件:
(a)電中性條件:ES凈電荷QES→0,等效襯底為準電中性,超結中N區和P區之間的電荷平衡得以滿足。
(b)均勻表面場條件:E (x,y,0) = 常數,等效襯底均勻表面場條件避免器件表面提前擊穿。
一種實現理想襯底條件的版圖如圖9所示,在超結耐壓方向上通過開不同窗口形成優化摻雜分布使得CCL與襯底保持電荷平衡,同時調制ES電場實現矩形分布。

圖9.滿足理想襯底條件的橫向超結版圖
3.超結工藝技術與新結構
由于結型耐壓層實現難度較大,很長一段時間內對超結器件的研究主要體現在工藝上,包括耐壓層實現技術與終端技術。同時將超結耐壓層用于不同的功率半導體器件中,實現特性改善或形成新型功率半導體器件。
3.1 工藝技術
超結工藝的難點是如何在耐壓層內部引入周期性的異型摻雜,如圖10所示為多次外延摻雜工藝,其中第一種方法通過多次外延一定濃度的N型區,然后僅采用P型注入補償形成超結P區;第二種方法是每次外延濃度較低,然后同時引入N和P型注入,分別形成超結的N區和P區,第二種工藝可以控制更好的均勻性,但工藝上需增加一次光刻與注入。此類工藝的優點是形成超結耐壓層的晶格質量較好,缺陷與界面態少。然而為形成較好超結形貌,每次外延層厚度相對固定且較薄,外延次數將隨著器件耐壓增大而增多,導致成本增加。

(a)單雜質注入

(b)雙雜質注入
圖10.多次外延工藝
另一種結型耐壓層實現工藝基于深槽刻蝕,如圖11所示,其中圖11(a)給出具有刻蝕槽的耐壓層結構。通過在超結耐壓層中刻蝕形成一定深寬比的槽,再對槽內部摻雜。第一種方式是在槽內外延填充P型硅,然后采用化學機械拋光平坦化實現超結耐壓層,拋光后耐壓層如圖11(b)所示。還可以在槽壁上形成薄氧化層結構,再進行多晶硅填充形成耐壓層;第2種方式是采用傾斜注入分別在槽壁上形成N區和P區,這樣可以控制N和P型雜質的注入劑量來實現電荷平衡,如圖11(c)所 示;第3種方式通過對槽壁氣相摻雜形成P型區,如圖11(d)所示。此外,還可以在槽壁選擇性外延薄層N與P型硅或者是直接通過P型雜質擴散形成超結耐壓層。采用刻槽填充工藝實現的超結耐壓層較多次外延技術更易實現較小的深寬比,同時形成的超結N區與P區摻雜分布也較均勻,有利于降低 Ron,sp。

(a)深槽刻蝕工藝

(b)外延填充

(c)斜角注入摻雜

(d)氣象摻雜
圖11.深槽工藝
為實現超結器件終端區高耐壓,有兩種典型超結器件終端結構,如圖12所示。圖12(a)表示具有變摻雜的終端結構,對多外延型工藝,可以改變P型注入區窗口,P型摻雜濃度從元胞到終端方向逐漸降低,保持終端區新的電荷平衡?;谏畈劭涛g的超結器件則主要通過優化終端區刻蝕窗口來實現類似變摻雜終端。圖12(b)給出采用常規表面終端技術的超結器件終端結構,其特點是將結型耐壓層埋入器件體內,減少超結內部PN結對器件表面場的影響,同時在器件終端區表面采用常規結終端技術實現高耐壓。
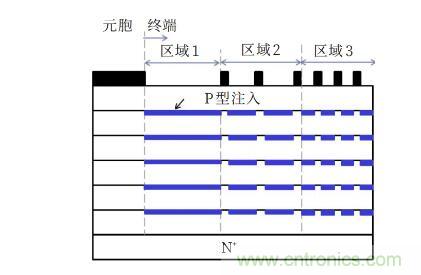
(a)變摻雜終端
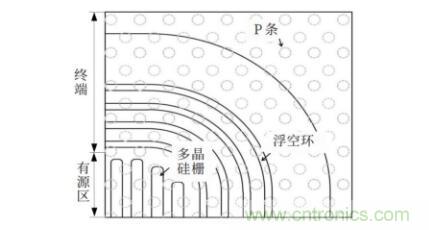
(b)表面終端技術
圖12.典型超結器件終端結構
超結不僅可以用來降低器件比導通電阻,同時可用以優化電場分布,如圖13所示為基于超結的終端結構,在常規浮空場限環間引入表面超結,建立新的電荷平衡,削弱了界面寄生電荷的影響,縮小終端區面積。

圖13.基于超結的終端結構
對橫向叉指型超結器件而言,由于表面超結結深較淺,容易在終端指尖位置提前擊穿,為解決此問題,作者團隊提出如圖14所示的襯底終端技術,通過將部分襯底電荷引入到器件表面,降低曲率效應,實現終端區新的電荷平衡,提高器件耐壓,且具有工藝兼容的優點。

圖14.襯底終端結構
3.2 超結新結構
3.2.1 縱向超結結構
對超結功率MOS器件而言,大量新結構致力于如何利用兼容工藝改善器件特性,圖15給出幾種改善器件特性的典型結構。圖15(a)為部分超結結構,超結器件給定元胞寬度下N區和P區的深寬比隨器件VB增加而增加,工藝難度增加。部分超結結構降低工藝難度,在相同深寬比條件下實現比全超結器件更低的Ron,sp且利于器件的反向恢復特性。
為了改善超結體二極管的反向恢復特性,通過集成肖特基二極管,提出如圖 15(b)所示的變形結構,通過肖特基結的反向抽取作用,削弱載流子存儲效應;隨著器件元胞寬度的進一步縮小,可能導致超結兩個P條之間距離過小難以形成溝道區,因此提出如圖15(c)所示的溝道與超結元胞相垂直的結構,該結構適用于窄元胞器件,減少溝道區工藝難度;此外還可以通過版圖優化減少部分溝道區面積,以實現更低的電磁干擾(EMI)噪聲。

圖15.改善超結MOS特性的新結構
超結作為一種典型的結型耐壓層結構,用于不同的器件可實現不同的功率半導體器件,典型結構如圖16所示。圖 16(a)為超結IGBT結構,與傳統IGBT相比,超結IGBT一方面通過電場調制縮小漂移區長度,另一方面還可以引入準單極傳導模式,即大注入電子和空穴分別流經低阻的超結N區和P區,器件關斷時通過內部PN結耗盡區擴展可以迅速抽取過剩載流子,實現快速關斷;作者團隊提出如圖16(b)所示的具有雙向耐壓特性的超結IGBT結構,該結構打破了一般超結IGBT正向壓降與超結區摻雜的依賴關系,實現開態雙極高電導調制與關態準單極關斷特性。如果將超結耐壓層用于二極管結構,則形成圖16(c)和 16(d)所示的超結junctionbarrier schottky rectifier(JBS)和 schottky barrier diode(SBD)器件結構,由于超結區的摻雜濃度很高,肖特基結開啟后有更小的正向壓降和更大的電流密度。同時由于反向阻斷狀態下P區之間的N型漂移區的耗盡層重疊形成勢壘,使器件反向漏電流降低。超結SBD器件還可采用槽型電極結構來降低肖特基接觸位置的電場,降低反向漏電。
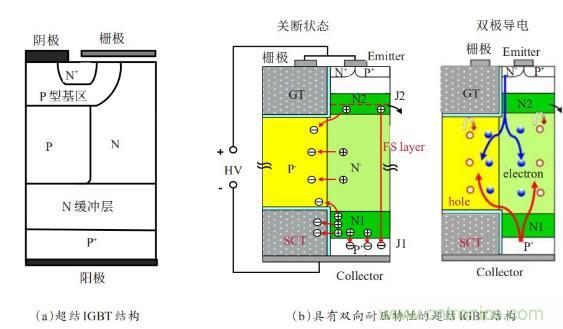
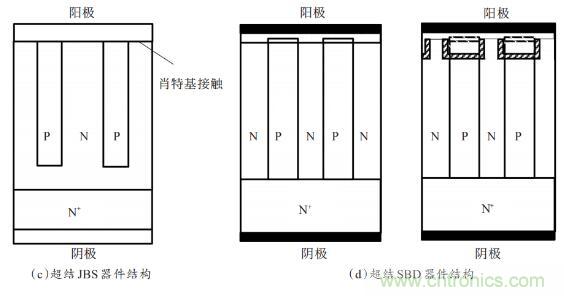
圖16.具有超結耐壓層的新型功率半導體器件
電荷平衡不僅可以通過PN結電離電荷實現,還可以通過金屬絕緣層半導體(metal insulator semiconductor,MIS)介質耦合實現,如圖17所示。其中圖17(a)和圖17(b)為具有高K介質的復合耐壓層結構,器件耐壓時大部分電通量通過高K介質流向表面,從而優化了硅層區電場;圖17(c)和圖17(d)為典型的體內場板結構,通過體內場板在耐壓層內部引入電荷,與硅層電離電荷保持平衡,優化體內電場降低器件Ron,sp。
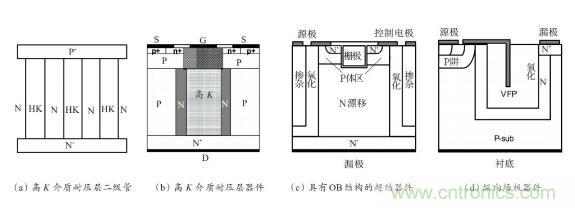
圖17.采用電荷平衡概念的新結構
3.2.2 橫向超結結構
橫向超結器件的發展主要集中在如何消除襯底輔助耗盡效應,典型方法有兩種。第1種方法如圖18所示,通過采用圖18(a)藍寶石襯底或者圖18(b)刻蝕去除硅襯底,其共同點都是消除襯底電位對表面超結區的影響,解決縱向耐壓低的問題。該方法可以很好地抑制襯底輔助耗盡效應,但具有工藝不兼容或者材料成本高的特點。
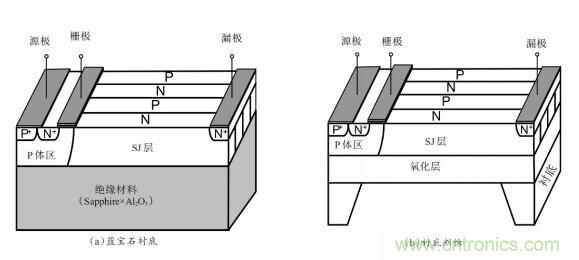
圖18.去除襯底影響的橫向超結結構
第2種方法如圖19所示,其基本思想是電荷補償,通過在耐壓層中引入補償電荷,與襯底電離電荷保持電荷平衡從而抑制襯底輔助耗盡效應的影響。從空間維度可以分為圖19(a)、圖19(b)x方向補償,主要是通過在超結區下方添加深N阱或者N緩沖層的形式實現;圖19(c)、圖19(d)y方向補償,超結區位于靠近源區,漏區為單一摻雜的N型摻雜,特別對SOI器件,為解決其耐壓較低的問題,可以采用局部薄層結構;圖19(e)、圖19(f)z方向補償,通過設計使超結N區和P區為非對稱形狀實現補償,與縱向器件類似,P區亦可采用高K介質。

圖19.電荷補償橫向超結結構
3.3 寬禁帶超結功率半導體器件
超結概念同樣被應用到寬禁帶半導體材料如SiC和GaN中,超結概念與理論完全適用,由于禁帶寬度更大,相同深寬比條件下,寬禁帶半導體超結器件對Ron,sp - VB關系的貢獻主要體現在系數項,可以降低約3個數量級,特別在超高壓領域非常具有吸引力。
如圖20所示是典型SiC基超結器件,采用與硅基類似的深槽刻蝕注入摻雜工藝實現,并且在槽內填充介質實現結型耐壓層結構,該工藝比較容易實現較高深寬比的超結區。對GaN材料而言,可以通過異型摻雜形成一般結型耐壓層結構,還可以利用疊層結構中電荷平衡極化電荷同時形成二維電子氣與二維空穴氣,典型結構如圖21所示。器件開態時電子氣和空穴氣同時參與導電,降低器件導通電阻,關態時極化電荷自動滿足電荷平衡,優化耐壓層電場,從而形成新型的電荷平衡耐壓層結構。
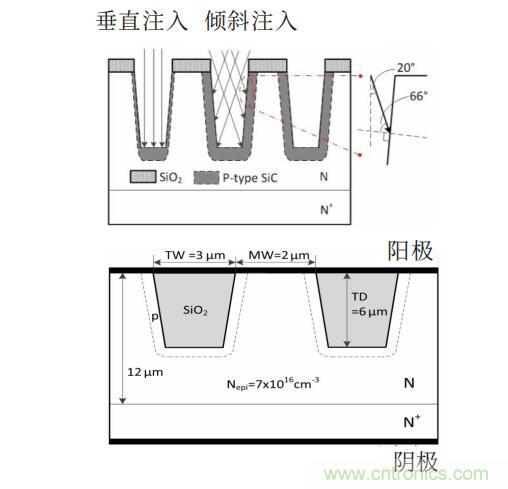
圖20.碳化硅基超結器件
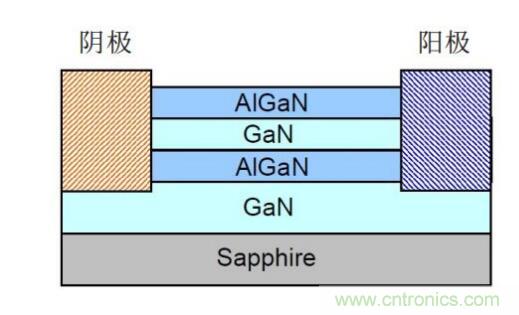
圖21.氮化鎵基超結器件
3.4 超結功率半導體器件發展歷程
綜上所述,超結發展歷程如圖22所示。超結結型耐壓層高壓低比導通電阻特性可實現高功率密度與低成本下的低損耗,理論上實現比導通電阻與耐壓的從Ron,sp ∝VB2.5關系降低到Ron,sp ∝VB1.32甚至Ron,sp ∝VB1.03關系,橫向超結器件優化可由等效襯底模型統一描述。
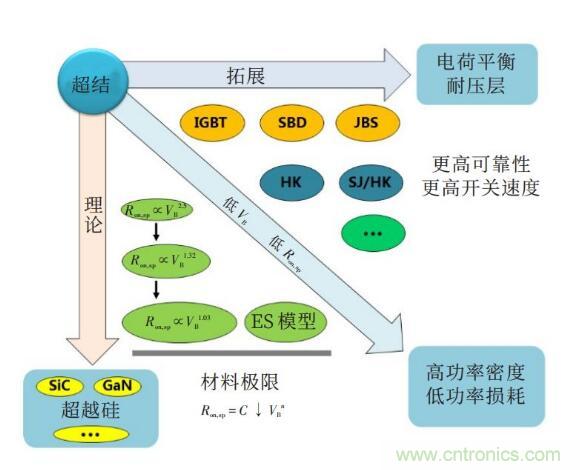
圖22.超結發展歷程
隨著元胞寬度進一步縮小,寄生JFET效應及齊納擊穿等變得更加顯著,經筆者計算,齊納擊穿限制下硅基超結的條寬極限約為0.1~0.2μm;超結概念完全適用于SiC、GaN等其他半導體材料,突破對應“硅極限”關系;另一方面,超結概念還被拓展到IGBT、SBD等其他功率半導體器件中,實現電荷平衡的耐壓層結構,并向著更高可靠性、更高開關速度的方向發展。
4.超結功率半導體器件展望
總結起來,目前在理論方面已經對超結器件做了較為深入的研究,獲得了其理論最低Ron,sp。然而,在實驗方面,超結器件特性仍有很大的提升空間,現有實驗結果與Ron,sp ∝VB1.03最低理論比導通電阻相比,在W為5~10μm范圍內,Ron,sp可以再降低20%~40%,而在W寬度為1~4μm范圍內,Ron,sp降低量達60%~80%,余量可觀。橫向超結器件是高壓功率集成技術的重要發展方向,目前研究主要集中在如何消除襯底輔助耗盡效應提高耐壓,然而超結本身優越的低阻特性尚待挖掘,特別采用具有縱向高深寬比的超結可以大幅降低 Ron,sp,作者團隊開發的具有N-top的橫向超結器件以及多次注入形成的NFD 橫向超結器件,Ron,sp均較Triple RESUF器件更優。因此橫向可集成超結器件有望成為Triple RESUF之后的下一代低阻可集成器件。
文獻來源:
張波, 章文通, 蒲松,等. 超結功率半導體器件[J]. 微納電子與智能制造, 2019, 1 (1): 5-19.
ZHANG Bo, ZHANG W T, PU S, et al. Superjunction power semiconductor devices[J]. Micro/nano Electronics and Intelligent Manufacturing, 2019, 1 (1): 5-19.
《微納電子與智能制造》刊號:CN10-1594/TN
主管單位:北京電子控股有限責任公司
主辦單位:北京市電子科技科技情報研究所 北京方略信息科技有限公司





